Service ListプラズマCVD装置
装置について
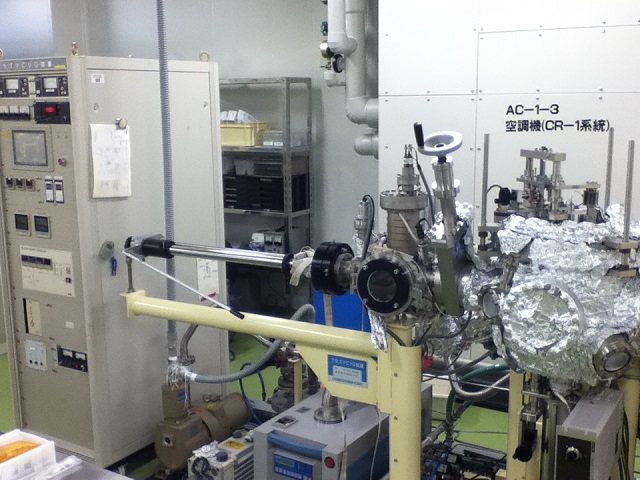
半導体ウェハー上に絶縁膜としてのSiO2膜を堆積させる装置です。TEOS(Tetraethyl orthosilicate)ガスと酸素ガスをチャンバー内に導入し、高周波によってプラズマを発生させることで、比較的低温でSiO2膜が成膜可能であり、半導体プロセスにおいて有効な手法となります。トランジスタのゲート酸化膜、表面パシベーション、半導体素子分離、マスクなど幅広く利用されています。
装置仕様
| メーカー・形式 | 日本真空技術株式会社(ULVAC)・UPC-3000S |
| 成膜材料 | SiO2膜 |
| 原料ガス | TEOS+O2 |
| 成膜室 ベース真空度 | 7×10-5Pa 成膜時圧力 6~133 Pa |
| 成膜速度 | 1nm/min 以上 |
| 基板温度 | 最大400℃(ランプ加熱) |
| 基板サイズ | 3”φウェハー以内(チップサイズ可) |
| 準備室 真空度 | 7×10-4Pa 基板予備加熱:300℃ |
| 膜厚分布 | ±10%以内 |

