Service Listスパッタリング装置
装置について
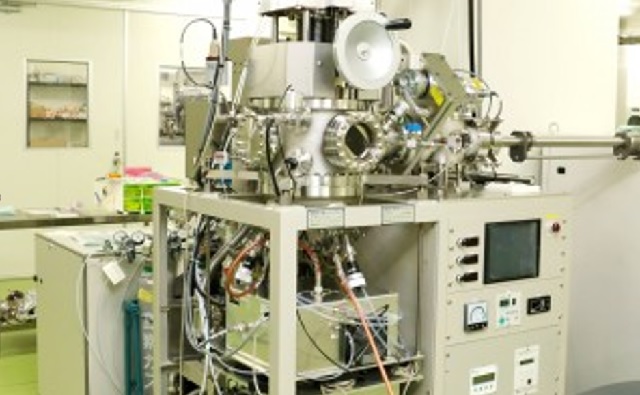
| 機能 | 試料上に各種薄膜を成膜する |
| 特長 | マグネトロン方式により高品質な膜の形成が可能。 3種のターゲットを同時に制御でき、様々な膜、積層構造の形成が可能。 |
| 用途 | 半導体プロセスにおける素子分離、マスク形成。ゲート絶縁膜。 その他多種多様な用途に応じた各種薄膜形成。 |
真空中でArなど不活性ガスを導入し、ターゲット(成膜材料)に負の高電圧を印加してプラズマを発生させます。
イオン化した不活性ガス原子は電界で加速され高速でターゲット表面に衝突します。
この衝撃でターゲット材料の粒子が飛び出し、基板上のサンプル表面に堆積させて薄膜を形成します。
高融点金属や合金など真空蒸着法では困難な材料の成膜も可能です。
装置仕様
| メーカー | 片桐エンジニアリング |
| 型式 | UTH-0503 |
| 成膜材料 | HfO2, SiO2 他 |
| 到達真空度 | 10-5 Pa 以下 |
| 基板加熱 | 室温~800℃ |
| 基板回転 | max.100 rpm |
| 基板サイズ | 2インチ以下 (チップ形状可) |
| スパッタソース | 水冷式マグネトロン方式 ターゲット:2インチ、3基 |

